지난 17일 천안-온양캠퍼스 찾아 패키징 기술 점검투자 확대 통해 파운드리 시장서 경쟁력 향상 행보 풀이미세공정 한계 대안 급부상… 글로벌 시장 연평균 4% 성장
-
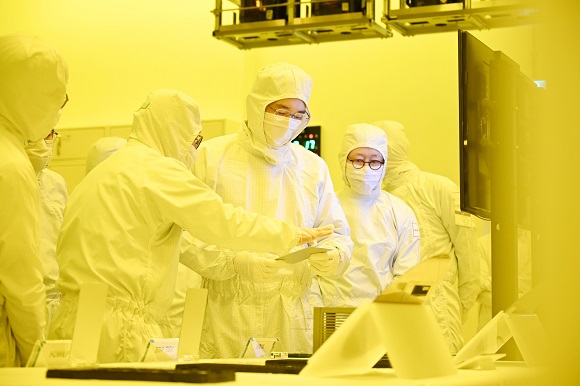
- ▲ 이재용 삼성전자 회장이 17일 삼성전자 천안캠퍼스를 찾아 패키지 라인을 둘러보고 사업전략을 점검했다.ⓒ삼성전자
이재용 삼성전자 회장이 반도체 패키징 사업을 직접 둘러보면서 그 배경에 관심이 모아지고 있다.패키징은 반도체 후공정 과정에서 핵심을 차지하는 기술로 여겨지는 만큼 2030년까지 시스템 반도체 분야 세계 1위를 선언한 삼성전자로선 필수적으로 가져가야 하는 분야라는 평가다.20일 관련업계에 따르면 이재용 삼성전자 회장은 지난 17일 삼성전자 천안캠퍼스와 온양캠퍼스를 찾아 ▲차세대 패키지 경쟁력 및 R&D 역량 ▲중장기 사업 전략 등을 점검했다.현재 삼성전자의 패키징 전용 생산라인은 충남 온양과 천안, 중국 쑤저우 등 총 세 곳에서 운영 중이다. 이재용 회장은 천안캠퍼스를 방문해 HBM(High Bandwidth Memory, 고대역폭 메모리), WLP(Wafer Level Package) 등 첨단 패키지 기술이 적용된 반도체 생산라인을 직접 살펴봤으며 온양캠퍼스로 이동해 패키지 기술 개발 부서 직원들과 간담회를 가졌다.삼성전자 천안·온양캠퍼스는 메모리 반도체와 파운드리(위탁생산) 등 반도체 제품의 테스트와 패키징, 출하를 담당하는 사업장이다. 온양캠퍼스는 1991년 처음 설립됐으며 고성능 반도체 패키징 수요가 증가하면서 디스플레이 사업장으로 쓰이던 천안캠퍼스에서도 2018년부터 패키징 라인을 운영하고 있다.이재용 회장은 "어려운 상황이지만 인재 양성과 미래 기술 투자에 조금도 흔들림이 있어서는 안된다"고 당부했다.이 회장이 반도체 패키징 사업에 직접 공을 들이는 이유는 초미세공정에 함께 패키지에도 투자 확대를 통해 파운드리 시장에서 경쟁력을 높이기 위한 것으로 풀이된다. 반도체 공정은 웨이퍼를 제조하고 회로를 새기는 전공정과 전공정을 마친 칩을 패키징하는 후공정으로 나뉘는데, 패키징 기술은 후공정에서도 핵심으로 분류된다.특히 반도체 미세공정 한계의 대안으로 패키징 기술이 떠오르는 상황이다. 글로벌 반도체 기업들이 미세화 속도가 둔화되면서 패키지 기술로 성능을 개선 및 비용 절감을 시도하고 있는 같은 맥락이다.미세 공정을 추가로 전개할수록 전공정 중에서 노광공정에 대한 설비투자 부담이 커지고 공정 과정이 복잡하기 때문에 후공정 기술을 통한 성능 개선에 나서고 있는 것이다.한국과학기술기획평가원에 따르면 반도체 패키징 세계시장은 지난 2015년부터 연평균 4.84% 성장을 보였다. 오는 2024년에는 849억 달러에 달할 것으로 전망된다. 국내 시장은 지난 2016년 131억 달러에서 연평균 4.8% 증가해 2024년에는 170억 달러를 나타낼 것으로 예상됐다. 국내 시장 점유율은 약 20% 수준으로 예측됐다.삼성전자는 지난 2018년 말 패키지 제조·연구조직을 통합해 TSP(Test & System Package)라는 총괄조직을 신설하고, 2019년에는 삼성전기 PLP(Panel Level Package) 사업부를 인수하는 등 차세대 패키징 역량 강화에 나서고 있다. 또한 지난해 말에는 조직개편을 통해 DS부문 내 패키지 사업 전담 조직인 AVP(어드밴스트 패키지)팀을 신설하는 등 관련 사업에 힘을 싣고 있는 상황이다.삼성전자는 지난 2020년 3D 적층 기술 X-Cube도 공개한 바 있다. X-Cube는 로직과 SRAM을 수직으로 적층한 3D 패키지 기술이다. 3D 패키지는 구성 요소를 수직으로 쌓아 칩 공간을 절약하며, 칩 사이의 공간을 줄임으로써 표면적을 줄이고 범핑 성능을 높인다.대형 사이즈의 칩을 제작할 때의 위험을 획기적으로 줄여줌으로써 높은 대역폭을 확보하고 저전력 성능을 유지하면서도 비용은 낮아진다. 삼성전자 I-Cube는 실리콘 인터포저 위에 CPU, GPU 등의 로직과 HBM을 배치해 하나의 반도체처럼 동작하도록 하는 2.5D 패키지 기술이다. 2.5D 패키지는 병렬 수평 칩 배치를 통해 칩에서 나오는 열을 배출하고 성능을 확장한다.글로벌 반도체 기업들도 패키징 사업에 공을 들이고 있다.TSMC는 2022년 3월 AMD의 고성능 컴퓨팅(HPC)용 CPU를 SoIC(System on Integrated Chip) 적층 패키지 기술로 양산했다. TSMC는 칩 사이 간격을 종전 대비 5분의 1 수준으로 줄여 전기 전도를 올리면서 속도를 올리고 에너지 효율을 높였다. 하이브리드 패키지 기술로 고성능 슈퍼컴퓨팅 시장의 공략 속도를 높일 예정이다.인텔은 레이크필드(Lakefield) 프로세서에 포베로스(Foveros) 3D 기술을 탑재해 새로운 프로세서 카테고리를 제시했다. 포베로스는 완전히 새로운 프로세서 구축 방식이다. 다양한 IP가 옆으로 펼쳐지는 것이 아니라, 위로 켜켜이 쌓이는 것이다. 하나의 칩을 기존 팬케이크 형태가 아닌 1 밀리미터 두께의 레이어를 쌓은 밀푀유(크레페케이크) 형태로 패키징한다.업계 관계자는 "반도체의 성능 향상이 다양한 패키징 방식을 통해 이뤄지면서 후공정 장비에 대한 중요성이 높아지고 있다"며 "후공정 장비의 경우 매출처가 다변화되어 있어 패키징 고도화에 따른 수요는 지속적으로 발생할 것"이라고 말했다.







