Kinex 하이브리드 본딩·Xtera 에피 등 3대 플랫폼 출시GAA·HBM·첨단 패키징 겨냥 … 2나노 이하 로직·메모리 지원공정 난이도 높아지는 AI 시대 … 수율 개선에 초점
-
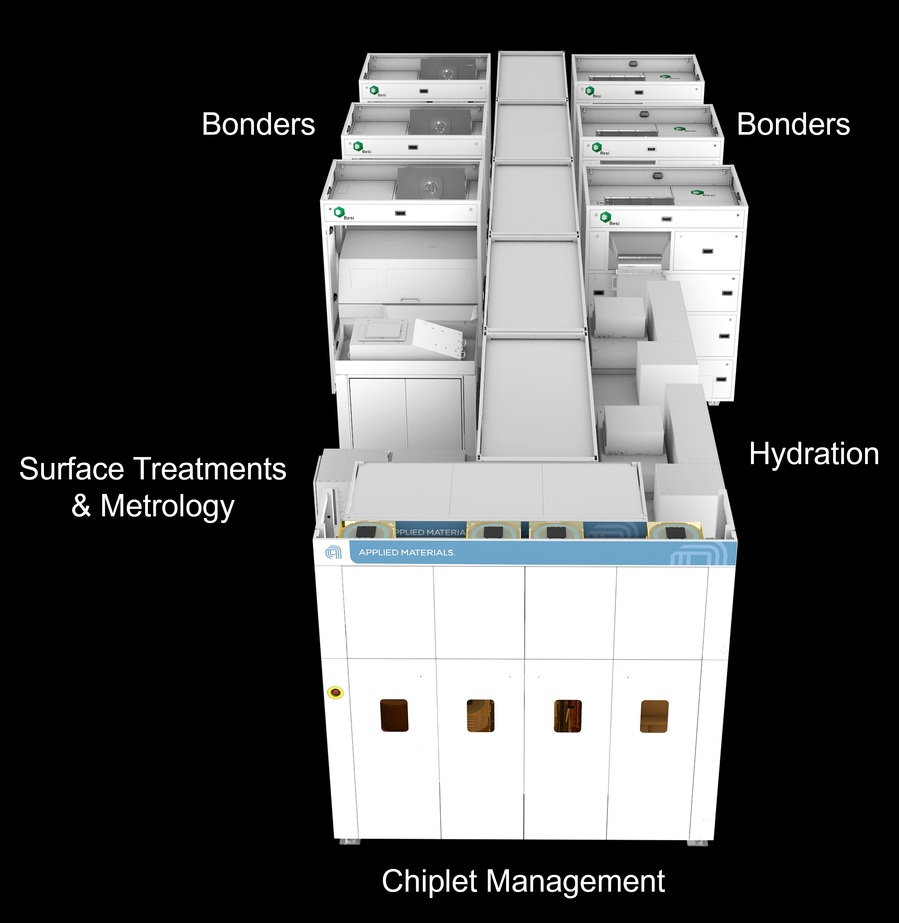
- ▲ 어플라이드 Kinex 본딩 시스템ⓒ어플라이드
어플라이드 머티어리얼즈가 AI 반도체 경쟁을 겨냥한 차세대 제조 장비 3종을 공개하며 로직·메모리·첨단 패키징 전 공정에서 성능·전력효율을 끌어올리는 솔루션 경쟁에 불을 붙였다. 2나노 이하 공정 확산과 칩렛 기반 패키징 수요 증가로 제조 난도가 급증하는 상황에서, 웨이퍼·패키징·계측을 아우르는 풀스택 기술력을 앞세워 고객사 로드맵 가속화에 나선다는 전략이다.어플라이드 머티어리얼즈는 26일 ▲다이 투 웨이퍼 하이브리드 본딩 통합 시스템 'Kinex' ▲GAA 트랜지스터용 보이드 프리 에피택시 플랫폼 'Centura Xtera' ▲차세대 전자빔 계측 장비 'PROVision 10'을 공개했다. 세 제품 모두 고성능 로직·HBM D램·3D 낸드를 중심으로 AI 칩 개발의 핵심 영역을 겨냥한다.프라부 라자 어플라이드 반도체 제품 그룹 사장은 "칩이 복잡해질수록 성능과 전력 효율을 높이기 위한 재료 공학 혁신이 더욱 중요해지고 있다"며 "고객사와 협력해 로직·메모리·첨단 패키징 분야에서 기술적 도약을 가능하게 하는 솔루션을 제공하겠다"고 말했다.칩렛 기반 패키징이 확산되면서 성능·전력·비용 경쟁력 확보를 위해 하이브리드 본딩의 중요성이 급부상하고 있다. 어플라이드는 베시(Besi)와 협력해 업계 최초로 모든 하이브리드 본딩 공정을 단일 장비에 통합한 'Kinex'를 선보였다.Kinex는 프론트엔드 웨이퍼 가공 기술과 베시의 고정밀 다이 배치·인터커넥트 기술을 결합해 더 작은 피치, 높은 본딩 정밀도, 공정 안정성을 구현한다.또한 다이 레벨 트레이싱·청정 환경 유지·인라인 계측 기능을 통해 멀티 다이 패키지의 품질과 수율을 향상한다. 현재 다수의 로직·메모리·OSAT 업체가 도입 중이다.GAA 트랜지스터 성능을 좌우하는 소스·드레인은 고종횡비 트렌치를 정밀하게 채우는 에피 공정 난도가 높다. 기존 방식은 보이드 발생과 불균일 성장으로 성능·신뢰성 저하 문제가 있었다.어플라이드의 'Centura Xtera'는 저용량 챔버에 프리클린·식각·증착을 통합해 가스 사용량을 50% 줄이면서도 보이드 없이 균일한 GAA 구조를 구현한다.증착과 식각을 반복하며 트렌치 개방 영역을 최적화하는 독자 기술로 트랜지스터 간 균일성을 40% 이상 높였다. 로직·메모리 고객사의 2나노 이하 공정에 이미 적용되고 있다.PROVision 10은 냉전계 방출(CFE) 기술을 적용해 기존 TFE 대비 해상도를 최대 50%, 이미징 속도를 최대 10배 높인 차세대 전자빔 계측 장비다.서브 나노미터급 이미징으로 GAA 트랜지스터·후면 전력 구조·HBM·3D 낸드 등 복잡한 3D 구조를 정밀하게 분석할 수 있다.EUV 오버레이 측정, 나노시트 계측, 에피 보이드 감지 등 공정 제어 기능을 통해 첨단 제조공정의 수율 향상을 지원한다.키스 웰스 어플라이드 이미징 및 공정 제어 그룹 부사장은 "3D 아키텍처가 확산되면서 기존 광학 계측이 한계에 직면했다"며 "고처리량 환경에서도 정밀 측정을 제공해 고객사 수율 개선을 적극 지원하겠다"고 말했다.







